Development and Validation of Source, Optics and Resist in Next Generation EUV Lithography
SOARING
|

INOE: Coated electrodes to ensure life time increase of the Micro Plasma Radiation Source
Large diameter water cooled electrodes to ensure life time increase of the Micro Plasma Radiation Source
 |
Grazing incidence mirrors for EUV lithography systems, resistant at energetic particle bombardment
- UHV resist exposure stand
Grazing incidence mirrors for EUV lithography systems, resistant at energetic particle bombardment

Design of the optical system for the EUV Lithography
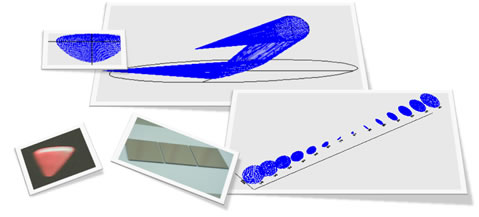
Highly reflective, highly resistance, low roughness EUV mirrors (l=13.5 nm) for the optical lithography system